מדוע וכיצד ליישם טרנזיסטורי אפקט שדה GaN עבור יישומי מערכות ספקי-כוח ממותגים במתח גבוה יותר ונצילות משופרת
באדיבות ‎DigiKey's North American Editors
2023-01-26
נצילות הספקת-הכוח היא בראש סדר העדיפויות של מערכות אלקטרוניות לנוכח דרישות חברתיות ורגולטוריות כאחד. במיוחד עבור יישומים החל מרכבים חשמליים (EVs) ועד תקשורת במתח גבוה ותשתיות תעשייתיות, נצילות המרת ההספק וצפיפות ההספק הן קריטיות עבור הצלחת התכנים.
כדי לעמוד בדרישות אלו, המתכננים של מערכות ספקי-כוח ממותגים צריכים לעבור משימוש בטרנזיסטורי אפקט-שדה תחמוצת מתכת (MOSFET) קלאסיים וטרנזיסטורים ביפולריים עם שער מבודד (IGBT) מבוססי סיליקון (Si), מכיוון שהם מתקרבים במהירות לגבולות התיאורטיים שלהם.
במקום זאת, המתכננים צריכים לשקול התקנים המבוססים על חומרים עם Bandgap-רחב (WBG) כגון גליום ניטריד (GaN). התקני GaN ממתגים מהר יותר מאשר התקני סיליקון (Si), מטפלים ברמות מתח והספק גבוהות יותר, הם קטנים בהרבה עבור רמת הספק נתונה ופועלים בנצילות הרבה יותר גבוהה.
מאמר זה יבחן את היסודות של GaN FETs, יציג את היתרונות שלהם על פני התקני סיליקון מסורתיים במעגלי ספקי-כוח ממותגים, יציג דוגמאות מהעולם-האמיתי של Nexperia, וידון ביישומים שלהם.
היסודות של GaN FETs
המרכיבים הבסיסיים במעגלי המרת הספק הם מתגי מוליכים-למחצה במתח גבוה. המתכננים התמקדו בשיפור הביצועים של התקנים אלה על ידי: הפחתת הפסדי הולכה על ידי הקטנת ההתנגדות הטורית במצב-מופעל, הפחתת הפסדי המיתוג על ידי הגדלת מהירויות המיתוג והפחתת השפעות פרזיטיות. מאמצי התכנון הללו, באופן כללי, היו מוצלחים עבור רכיבי סיליקון MOSFET ו-IGBT, אך קצב השיפור הלך והואט כאשר פעולתם של התקנים אלו מגיעה לגבולות התיאורטיים שלהם.
כתוצאה מכך הושקו בשנים האחרונות התקני WBG המשתמשים בסיליקון קרביד (SiC) ו-GaN, עד כדי כך שהם הגיעו לייצור בכמויות. התקנים אלה מציעים תחומי מתחי פעולה גבוהים יותר, זמני מיתוג מהירים יותר ונצילות גבוהה יותר.
ה-Bandgap של מוליך-למחצה הוא האנרגיה המינימלית הנדרשת כדי לעורר אלקטרונים כדי לשחרר אותם מהמצב הכבול למצב חופשי כדי להוליך חשמל (טבלה 1).
|
טבלה 1: סיכום של המאפיינים העיקריים המבדלים מוליכים-למחצה עם Bandgap רחב- כגון GaN ו- SiC - מסיליקון (Si). (מקור הטבלה: Art Pini)
התקנים העשויים עם מוליכים-למחצה עם Bandgap-רחב יכולים לפעול במתחים, תדרים וטמפרטורות הרבה יותר גבוהים לעומת חומרים מוליכים-למחצה קונבנציונליים כמו סיליקון (Si). Bandgap רחב יותר חשוב במיוחד כדי לאפשר להתקנים לפעול בטמפרטורות הרבה יותר גבוהות. טולרנס טמפרטורה גבוה פירושו שבתנאים רגילים ניתן להפעיל התקנים אלו ברמות הספק הרבה יותר גבוהות. מוליכים-למחצה WBG עם שדה חשמלי קריטי גבוה יותר וניידות גבוהה יותר הם בעלי התנגדות מרזב-מקור (D-S) במצב-מופעל ((DS(ONR) הנמוכה ביותר, המקטינה את הפסדי ההולכה.
לרוב החומרים עם Bandgap-רחב יש גם מהירויות גבוהות של אלקטרונים חופשיים, המאפשרות להם לעבוד במהירויות מיתוג גבוהות יותר.
בהשוואה ל-Si, שלו Bandgap של 1.12 אלקטרון-וולט (eV), GaN ו-SiC הם מוליכים-למחצה מרוכבים עם Bandgap שהוא בערך פי שלושה גבוה יותר ב-eV 3.4 ו-eV 3.3, בהתאמה. המשמעות היא ששניהם יכולים לתמוך במתחים גבוהים יותר ובתדרים גבוהים יותר.
ניידות האלקטרונים הגבוהה יותר של GaN הופכת אותו למתאים הרבה יותר עבור יישומים עם ביצועים עיליים בתדר גבוה. מהירויות המיתוג הגבוהות יותר ותדרי הפעולה הגבוהים יותר המאופשרים על ידי FETs להספק GaN מביאים לשיפור בקרת האותות, תכני מסננים פסיביים עם תדרי קיטעון גבוהים יותר וזרמי אדווה נמוכים יותר. זה מאפשר שימוש במשרנים, קבלים ושנאים קטנים יותר, וכתוצאה מכך גודל ומשקל כולל מופחת.
GaN FETs נקראים טרנזיסטורי ניידות אלקטרונים גבוהה (HEMT). ניידות האלקטרונים הגבוהה היא פונקציה של מבנה ה-FET (איור 1).
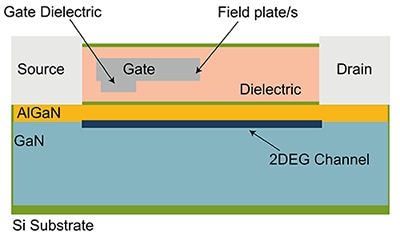 איור 1: חתך-רוחב של GaN FET המבוסס על מצע Si. (מקור התמונה: Nexperia)
איור 1: חתך-רוחב של GaN FET המבוסס על מצע Si. (מקור התמונה: Nexperia)
GaN FETs משתמשים במתקני ייצור CMOS סיליקון קיימים, ההופכים אותם ליעילים וחסכוניים. שכבת GaN נוצרת על מצע Si על ידי שיקוע שכבה גרעינית ושכבה מדורגת של GaN ואלומיניום גליום ניטריד (AlGaN) כשכבת בידוד (לא מוצגת באיור) לפני שמגדלים את שכבת GaN הטהורה. שכבת AlGaN שנייה משוקעת על גבי שכבת ה-GaN. זה יוצר קיטוב פיזואלקטרי, כאשר עודף של אלקטרונים נוצר סמוך ומתחת ל-AlGaN, שהוא תעלה מוליכה ביותר. עודף זה של אלקטרונים ידוע בתור גז אלקטרוני דו-ממדי (2DEG). השם משקף את ניידות האלקטרונים הגבוהה ביותר בשכבה זו.
אזור מיחסור (Depletion) נוצר מתחת לשער. פעולת השער דומה ל-MOSFET סיליקון להספק תעלת-N אופן-מוגבר. מתח חיובי המופעל על השער של התקן זה מתניע אותו למצב-מופעל.
מבנה זה חוזר על עצמו מספר פעמים כדי ליצור התקן להספק. התוצאה הסופית היא פתרון פשוט, אלגנטי, יעיל וחסכוני עבור מיתוג הספק.
כדי להשיג התקן במתח גבוה יותר, המרחק בין המרזב (Drain) לבין השער הוגדל. מכיוון שההתנגדות של ה-2DEG של ה-GaN היא נמוכה ביותר, ההשפעה על ההתנגדות של הגדלת יכולת המתח החוסם היא נמוכה בהרבה בהשוואה להתקני סיליקון.
ניתן לבנות GaN FETs לפעולה בשתי תצורות, אופן-מוגבר או אופן-מיחסור (Depletion). FETs אופן-מוגבר הם במצב כבוי באופן רגיל, ולכן יש להפעיל מתח חיובי יחסית למרזב/מקור על השער כדי להפעיל את ה-FET. FETs אופן-מיחסור הם במצב מופעל באופן רגיל, ולכן יש להפעיל מתח שער שלילי יחסית למרזב/מקור כדי להעביר את ה-FET למצב כבוי. FETs אופן-מיחסור הם בעייתיים במערכת הספקת-כוח מכיוון שיש להפעיל ממתח שלילי על ה-FET אופן-מיחסור GaN לפני הפעלת הספקת-הכוח למערכת.
דרך אחת לעקוף בעיה זו היא לשלב FET סיליקון במתח נמוך עם GaN FET אופן מיחסור בתצורת מעגל Cascode (איור 2).
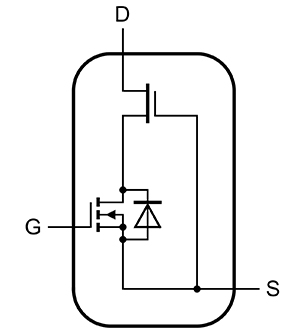 איור 2: MOSFET סיליקון במתח נמוך בתצורת Cascode עם GaN FET אופן מיחסור מביא לחוסן של מבנה שער Si עם מאפייני השעון במתח גבוה המשופרים של התקן GaN, כמו גם - במקרה של GaN FET אופן מיחסור - כיבוי ההתקן המרוכב בעת הפעלת הספקת-הכוח. (מקור התמונה: Nexperia)
איור 2: MOSFET סיליקון במתח נמוך בתצורת Cascode עם GaN FET אופן מיחסור מביא לחוסן של מבנה שער Si עם מאפייני השעון במתח גבוה המשופרים של התקן GaN, כמו גם - במקרה של GaN FET אופן מיחסור - כיבוי ההתקן המרוכב בעת הפעלת הספקת-הכוח. (מקור התמונה: Nexperia)
מעגל ה-Cascode משתמש במבנה שער Si MOSFET שלו יתרונות של גבולות דוחף שער גבוהים יותר המתאימות ל-ICs הקיימים של דוחפי שער MOSFET, וה-GaN FET אופן מיחסור הוא כבוי בעת הפעלת הספקת-הכוח.
אחד המאפיינים העיקריים של GaN FETs הוא הנצילות הגבוהה שלהם. זה נובע מ-: התנגדות טורית נמוכה, המקטינה את הפסדי ההולכה; זמני המיתוג המהירים יותר שלהם, המקטינים את הפסדי המיתוג; ומטען התאוששות-אחורנית הנמוך יותר שלהם, התורם להפסדי התאוששות-אחורנית הנמוכים שלהם.
באמצעות טופולוגיה נפוצה של ממיר מעלה-מתח חצי-גשר, ניתן להשוות את הנצילות של GaN FETs ו-Si MOSFETs (איור 3).
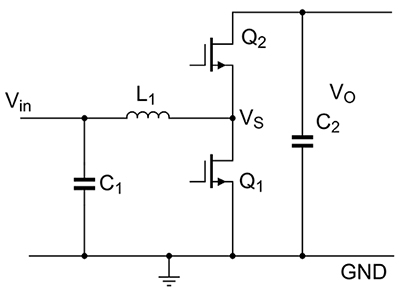 איור 3: תיאור סכמטי של ממיר מעלה-מתח חצי-גשר המשמש להשוואת הנצילות של MOSFETs ו- GaN FETs על ידי החלפת טרנזיסטורים Q1 ו-Q2 עם כל סוג. (מקור התמונה: Nexperia)
איור 3: תיאור סכמטי של ממיר מעלה-מתח חצי-גשר המשמש להשוואת הנצילות של MOSFETs ו- GaN FETs על ידי החלפת טרנזיסטורים Q1 ו-Q2 עם כל סוג. (מקור התמונה: Nexperia)
לממיר מעלה-מתח יש מתח כניסה של 240 וולט, מתח יציאה של 400 וולט ותדר המיתוג הוא 100 קילו-הרץ (kHz). הנצילויות וההפסדים מושווים על-פני תחום הספקים של עד 3500 וואט (איור 4).
 איור 4: השוואה בין הנצילות והפסדי ההספק בין GaN FETs ו-MOSFETs במעגל זהה המציגה את היתרונות של GaN FETs. (מקור התמונה: Nexperia)
איור 4: השוואה בין הנצילות והפסדי ההספק בין GaN FETs ו-MOSFETs במעגל זהה המציגה את היתרונות של GaN FETs. (מקור התמונה: Nexperia)
התקני GaN FET פועלים בנצילות גבוהה יותר בכ-20% בהשוואה ל-MOSFET, והפסדי ההספק נמוכים פי שלושה בערך. ב-2,000 וואט, ההפסדים ב-MOSFET הם כ-62 וואט; ב-Gan FET הם רק 19 וואט. המשמעות היא שמערכת הקירור יכולה להיות קטנה יותר, ובכך לשפר את הנצילות הנפחית של הממיר מוריד-מתח.
פחות ברור הוא שהמדידה בוצעה עד קרוב ל-3,500 וואט עבור GaN FET הודות לגבול המתח המקסימלי שלו שהוא גבוה יותר. ככזה, ל-GaN FET יש יתרון מובהק.
צעדים ראשונים עם GaN עבור מתחים גבוהים יותר
עבור יישומי מתח גבוה יותר, Nexperia מציעה שני GaN FET 650 וולט, GAN063-650WSAQ ו-GAN041-650WSBQ. שניהם הם FETs תעלת-N שהם כבויים באופן רגיל. ה-GAN063-650WSAQ מדורג להתמודד עם מתח מרזב-מקור מקסימלי של 650 וולט ויכול לעמוד בטרנזיינטיים (ברוחב פולס של פחות ממיקרו-שנייה) של 800 וולט. הוא מדורג זרם מרזב (Drain) של 34.5 אמפר (A) ופיזור הספק של 143 וואט ב-25°C. התנגדות מרזב-למקור טיפוסית במצב-מופעל היא 50 מילי-אוהם (mΩ), עם גבול מקסימלי של mΩ 60.
ל-GAN041-650WSBQ יש את אותו דירוג מתח מרזב-למקור מקסימלי של 650 וולט עם אותו גבול טרנזיינטים של 800 וולט. הוא שונה בכך שהוא יכול להתמודד עם זרם מרזב מקסימלי של A 47.2 ופיזור הספק מקסימלי של 187 וואט בטמפרטורת החדר. התנגדות התעלה הטיפוסית שלו היא mΩ 35, עם מקסימום של mΩ 41.
תכן ייחוס של Nexperia המשתמש ב-GAN063-650WSAQ בתצורת חצי-גשר מוצג באיור 5.
 איור 5: תכן מומלץ עבור דרגת הספק חצי-גשר באמצעות GAN063-650WSA GaN FETs. הסכימה מציגה רק את דוחף ה-FET ואת דרגת היציאה חצי-גשר, וכן רכיבים קשורים. (מקור התמונה: Nexperia)
איור 5: תכן מומלץ עבור דרגת הספק חצי-גשר באמצעות GAN063-650WSA GaN FETs. הסכימה מציגה רק את דוחף ה-FET ואת דרגת היציאה חצי-גשר, וכן רכיבים קשורים. (מקור התמונה: Nexperia)
הסכימה מציגה את דוחף השער המבודד הכפול גבוה/נמוך Si8230, המשמש לדחיפת השערים של ה-GaN FETs. היציאה של דוחף השער מחוברת לשער באמצעות נגד שער Ω 30, הנדרש עבור כל התקני GaN. נגד השער מבקר את זמן הטעינה של קיבוליות השער ובכך משפיע על ביצועי המיתוג הדינמי. רשתות ה-RC בין המרזב והמקור של ה-FET מסייעות גם בבקרת ביצועי המיתוג. רמות דוחף השער עבור GaN FET הן בין 0 ל-10 עד 12 וולט.
מהירות המיתוג הגבוהה של GaN FETs (בדרך כלל בתחום של 10 עד 11 ננו-שניות (ns)) מחייבת פריסה קפדנית כדי למזער השראות פרזיטית, וכן שימוש במשככי מתחים טרנזינטיים (Snubbers) כדי לשכך Ringing עקב טרנזיינטי מתח וזרם. בתכן ישנם מספר Snubbers RC (R17 עד R19 ו-C33 עד C35) בין הספקת המתח הגבוה לבין ההארקה. ה-Snubbers מפחיתים את ה-Ringing הנגרם על ידי האינטראקציה של ה-GaN FET ורשת המעקף. את ה-Snubbers יש לחבר קרוב ככל האפשר למרזב ה-FET צד-גבוה. הם ממומשים עם נגדים בהרכבה-משטחית וקבלים קרמיים עם התנגדות טורית אפקטיבית (ESR) נמוכה כדי למזער את השראות המוליכים.
רשת הרכיבים שנוצרה על ידי 4R, 1D, 12C ו-13C היא ספק-כוח Bootstrap עבור דוחף השער צד-גבוה. 1D צריכה להיות דיודה מהירה עם קיבוליות נמוכה מכיוון שקיבוליות הצומת שלה תורמת להפסדי מיתוג. 4R מגביל את זרם הטעינה בהתנעה; ערך בתחום של Ω 10 עד Ω 15 עובד היטב.
סיכום
החל מרכבים חשמליים ועד לתשתיות לתעשייה ותקשורת, הצורך בנצילות גבוהה יותר של המרת הספק וצפיפות הספק דורש שינוי ממבני Si קלאסיים. כפי שהוצג, GaN FETs מספקים דרך קדימה עבור התכנים של הדור-הבא על ידי היצע של מתחי פעולה גבוהים יותר, זמני מיתוג מהירים יותר ונצילות גבוהה יותר. רכיבים מן-המדף, הנתמכים במקרים מסוימים על ידי תכני ייחוס, עוזרים למתכננים להפעיל פרויקטים במהירות.

מיאון אחריות: דעות, אמונות ונקודות מבט המובעות על ידי מחברים שונים ו/או משתתפי פורום באתר אינטרנט זה לא בהכרח משקפות את הדעות, האמונות ונקודות המבט של חברת DigiKey או את המדיניות הרשמית של חברת DigiKey.